| 导语: LED封装的功能主要包括:1、机械保护,以提高可靠性;2、加强散热,以降低晶片结温,提高LED性能;3、光学控制,提高出光效率,优化光束分布;4、供电管理,包括交流/直流转变,以及电源控制等。
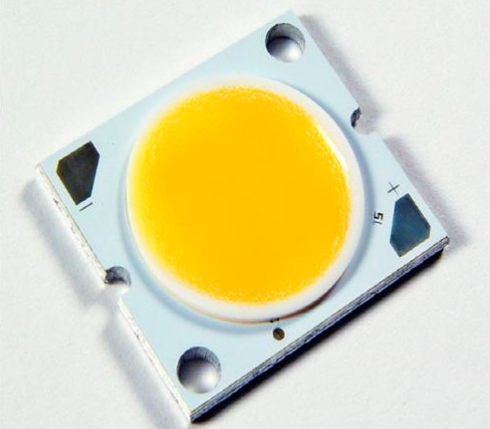
LED封装方法、材料、结构和工艺的选择主要由晶片结构、光电/机械特性、具体应用和成本等因素决定。经过40多年的发展,LED封装先后经历了支架式(Lamp LED)、贴片式(SMD LED)、裸芯型LED(COB LED)等发展阶段。
大功率LED封装主要涉及光、热、电、结构与工艺等方面。这些因素彼此既相互独立,又相互影响。其中,光是LED封装的目的,热是关键,电、结构与工艺是手段,而性能是封装水平的具体体现。从工艺相容性及降低生产成本而言,LED封装设计应与晶片设计同时进行,即晶片设计时就应该考虑到封装结构和工艺。否则,等晶片制造完成后,可能由于封装的需要对晶片结构进行调整,从而延长了产品研发周期和工艺成本,有时甚至不可能。对于现有的LED光效水平而言,由于输入电能的80%左右转变成为热量,且LED晶片面积小,因此,晶片散热是LED封装必须解决的关键问题。主要包括晶片布置、封装材料选择(基板材料、热介面材料)与工艺、热沉设计等。

LED封装热阻主要包括材料(散热基板和热沉结构)内部热阻和介面热阻。散热基板的作用就是吸引晶片产生的热量,并传导到热沉上,实现与外界的热交换。常用的散热基板材料包括矽、金属(如铝,铜)、陶瓷(如Al2O3,AIN,Sic)和复合材料等。研究表明,封装介面对热阻影响也很大,如果不能正确处理介面,就难以获得良好的散热效果。
在LED使用过程中,辐射复合产生的光子在向外发射时产生的损失,主要包括三个方面:晶片内部结构缺陷以及材料的吸收;光子在出射界面由于折射率差引起的反射损失;以及由于入射角大于全反射临界角而引起的全反射损失。因此,很多光线无法从晶片中出射到外部。通过在晶片表面涂覆一层折射率相对较高的透明胶层(灌封胶),由于该胶层处于晶片和空气之间,从而有效减少了光子在介面的损失,提高了取光效率。此外,灌封胶的作用还包括对晶片进行机械保护,应力释放,并作为一种光导结构。因此,要求其透光率高,折射率高,热稳定性好,流动性好,易于喷涂。为提高LED封装的可靠性,还要求灌封胶具有低吸湿性、低应力、耐老化等特性。目前常用的灌封胶包括环氧树脂和矽胶。矽胶由于具有透光率高,折射率大,热稳定性好,应力小,吸湿性低等特点,明显优于环氧树脂,在大功率LED封装中得到广泛应用,但成本较高。研究表明,提高矽胶折射率可有效减少折射率物理屏障带来的光子损失,提高外量子效率,但矽胶性能受环境温度影响较大。随着温度升高,矽胶内部的热应力加大,导致矽胶的折射率降低,从而影响LED光效和光强分布。萤光粉的作用在于光色复合,形成白光。其特性主要包括粒度、形状、发光效率、转换效率、稳定性(热和化学)等,其中,发光效率和转换效率是关键。研究表明,随着温度上升,萤光粉量子效率降低,出光减少,辐射波长也会发生变化,从而引起白光LED色温、色度的变化,较高的温度还会加速萤光粉的老化。传统的萤光粉涂敷方式是将萤光粉与灌封胶混合,然后点涂在晶片上。由于无法对萤光粉的涂敷厚度和形状进行精确控制,导致出射光色彩不一致,出现偏蓝光或者偏黄光经过40多年的发展,LED封装技术和结构先后经历了四个阶段。引脚式封装就是常用的 3-5mm封装结构。一般用于电流较小(20-30mA),功率较低(小于0、1W)的LED封装。主要用于仪表显示或指示,大规模集成时也可作为显示屏。其缺点在于封装热阻较大(一般高于100K/W),寿命较短。表面组装技术(SMT)是一种可以直接将封装好的器件贴、焊到PCB表面指定位置上的一种封装技术。具体而言,就是用特定的工具或设备将芯片引脚对准预先涂覆了粘接剂和焊膏的焊盘图形上,然后直接贴装到未钻安装孔的PCB 表面上,经过波峰焊或再流焊后,使器件和电路之间建立可靠的机械和电气连接。SMT技术具有可靠性高、高频特性好、易于实现自动化等优点,是电子行业最流行的一种封装技术和工艺。COB是Chip On Board(板上芯片直装)的英文缩写,是一种通过粘胶剂或焊料将LED芯片直接粘贴到PCB板上,再通过引线键合实现芯片与PCB板间电互连的封装技术。PCB板可以是低成本的FR-4材料(玻璃纤维增强的环氧树脂),也可以是高热导的金属基或陶瓷基复合材料(如铝基板或覆铜陶瓷基板等)。而引线键合可采用高温下的热超声键合(金丝球焊)和常温下的超声波键合(铝劈刀焊接)。COB技术主要用于大功率多芯片阵列的LED封装,同SMT相比,不仅大大提高了封装功率密度,而且降低了封装热阻(一般为6-12W/m、K)。SiP(System in Package)是近几年来为适应整机的便携式发展和系统小型化的要求,在系统芯片System on Chip(SOC)基础上发展起来的一种新型封装集成方式。对SiP-LED而言,不仅可以在一个封装内组装多个发光芯片,还可以将各种不同类型的器件(如电源、控制电路、光学微结构、传感器等)集成在一起,构建成一个更为复杂的、完整的系统。同其他封装结构相比,SiP具有工艺兼容性好(可利用已有的电子封装材料和工艺),集成度高,成本低,可提供更多新功能,易于分块测试,开发周期短等优点。按照技术类型不同,SiP可分为四种:芯片层叠型,模组型,MCM型和三维(3D)封装型。晶片键合(Wafer bonding)技术是指芯片结构和电路的制作、封装都在晶片(Wafer)上进行,封装完成后再进行切割,形成单个的芯片(Chip);与之相对应的芯片键合(Die bonding)是指芯片结构和电路在晶片上完成后,即进行切割形成芯片(Die),然后对单个芯片进行封装(类似现在的LED封装工艺)。很明显,晶片键合封装的效率和质量更高。由于封装费用在LED器件制造成本中占了很大比例,因此,改变现有的LED封装形式(从芯片键合到晶片键合),将大大降低封装制造成本。此外,晶片键合封装还可以提高LED器件生产的洁净度,防止键合前的划片、分片工艺对器件结构的破坏,提高封装成品率和可靠性,因而是一种降低封装成本的有效手段。此外,对于大功率LED封装,必须在芯片设计和封装设计过程中,尽可能采用工艺较少的封装形式(Package-less Packaging),同时简化封装结构,尽可能减少热学和光学界面数,以降低封装热阻,提高出光效率。LED器件的失效模式主要包括电失效(如短路或断路)、光失效(如高温导致的灌封胶黄化、光学性能劣化等)和机械失效(如引线断裂,脱焊等),而这些因素都与封装结构和工艺有关。LED的使用寿命以平均失效时间(MTTF)来定义,对于照明用途,一般指LED的输出光通量衰减为初始的70%(对显示用途一般定义为初始值的50%)的使用时间。由于LED寿命长,通常采取加速环境试验的方法进行可靠性测试与*估。测试内容主要包括高温储存(100℃,1000h)、低温储存(-55℃,1000h)、高温高湿(85℃/85%,1000h)、高低温循环(85℃~-55℃)、热冲击、耐腐蚀性、抗溶性、机械冲击等。然而,加速环境试验只是问题的一个方面,对LED寿命的预测机理和方法的研究仍是有待研究的难题。 |